③ MCM:20世紀90年代初隨著LSI設計技術和工藝技術的進步,以及深亞微米技術和微細化芯片尺寸等技術的應用,即將多個LSI芯片組裝在一個多層布線的外殼內,形成了MCM多芯片封裝器件。近年來,MCM技術通過FOP(堆疊封裝)的形式,將2~4個裸片裝在球柵陣列封裝基板上,出現了多芯片模塊(MCM),如圖3所示。

圖3
過去所說的MCM是指在一塊基板上組裝多個半導體芯片和元器件,近些年來半導體制造商開始由供應組裝了多個芯片的存儲器轉向供應組裝有多個芯片的SiP。SoC、SiP、MCM模組化微芯片技術的應用,導致了傳統的電路設計技術發生了歷史性的變革,設計和工藝的技術界限越來越模糊了。傳統的電路設計技術功能越來越退化(未來的電路設計功能更多地是選用合適的芯片級功能模塊及其接口類型),而微組裝工藝技術卻得到了極大的發展。未來電子裝備的可靠性越來越取決于微電子組裝工藝技術的發展。
例如:
●SiP使用的技術要素最基本的是CSP中所使用技術的組合。
●作為新加入的要素技術是芯片薄化加工技術、芯片積層技術、芯片積層中的互連技術。
●SiP安裝形態目前包括:在印制板上平面配置芯片的形態(主要使用BGA),在印制板上直接積層芯片的形態(主要使用CSP),最近也使用了倒裝芯片連接方式。
●芯片堆疊最具經濟效益的是4~5個芯片的堆疊。“聚合物中芯片”工藝不采用金絲球焊,而是將芯片減薄后嵌入到薄膜或聚合物基中,如圖4所示。
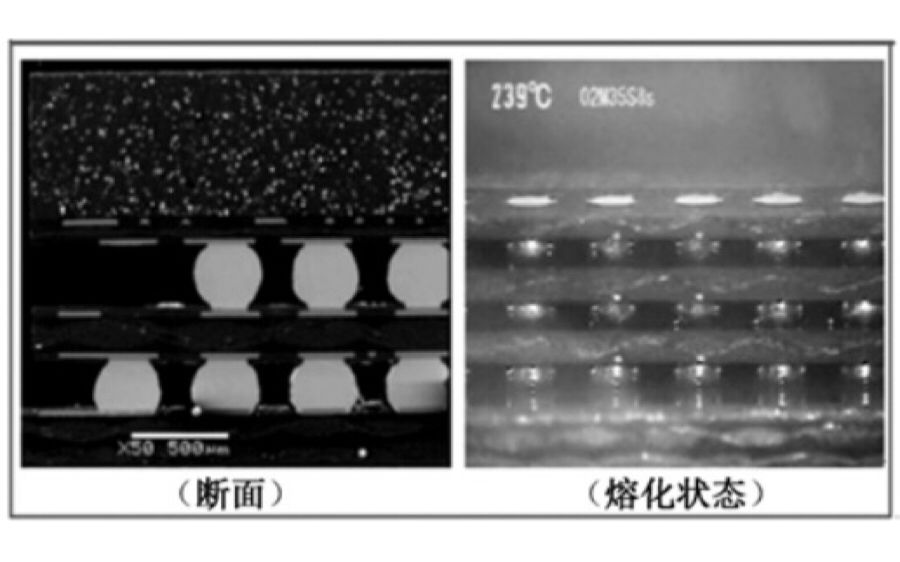
圖4
(5)電子設備的安裝密度不斷增加。從第一代電子管進入第二代晶體管,后又從小、中規模集成電路進入到大規模和超大規模集成電路,電子產品正朝小型化、微型化,立體化封裝方向發展。其結果導致裝置安裝密度的不斷增加,從而使內部溫升增高,散熱條件惡化。而電子元器件將隨環境溫度的增高,降低其可靠性,因而元器件(特別是功率芯片)的可靠性引起了人們的極大重視。
(6)將無源元件R、C、L(甚至IC裸芯)內藏于PCB基板中,然后再將未封裝的IC芯片或IC封裝貼裝或綁接到內藏無源元件的基板表面,完成全部組裝過程,如圖5所示。
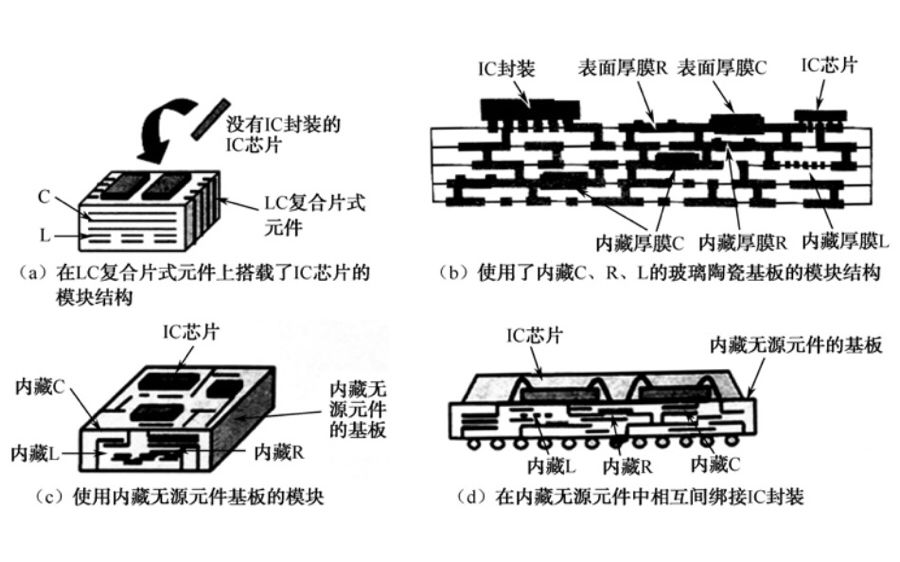

圖5
HDI-PCB技術、內藏元器件基板技術,以及SoP、SiP及MCM等的結合,驅動了電子設備技術邁入了第五代。它改變了傳統的由前決定后的串行組裝模式,而邁入了前后并行的微組裝模式的新時代。傳統的產品可靠性管理和評估模式將面臨著嚴重的挑戰。由于有源和無源芯片封裝的高集成化,系統安裝的高密度化和立體化,焊接點的微細化和不可視化,導致了微組裝工藝可靠性問題將變得異常突出。